-
Inductively Coupled Plasma-Optical Emission Spectroscope (ICP-OES)
(ICPS-7510:SHIMADZU CORPORATION)
ICP-OES is used for the quantitative analysis of trace impurities in aqueous solutions (plating solutions, etc.). Many elements are analyzed quantitatively in the ppm range, as samples are ionized by high-temperature plasma and less affected by coexistent elements.
-
Desktop Wire Bonder (WB)
(HB16:TPT Japan Co., Ltd.)
Wire Bonder connects gold, aluminum and copper wires (17-75 μm diameter) to semiconductor components. A variety of components are evaluated by both wedge bonding and ball bonding.
-
High Performance Liquid Chromatograph (HPLC)
(Prominence:SHIMADZU CORPORATION)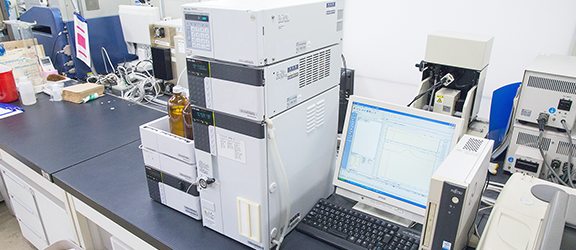
HPLC is used for the analysis of impurities and ingredients in plating solutions. By passing through mixed samples including plating solutions, each ingredient is separated by interaction with stationary phase columns.
-
Field Emission-Scanning Electron Microscope (FE-SEM)
(S-4300:Hitachi High-Technologies Corporation)
FE-SEM is used for observing fine structure of sample surfaces. Secondary electron, backscattered electron and EDX detectors are available. Observation of noble metal plating surface on the order of several tens of nanometers and cross sectional elemental analysis of plated coatings fabricated by focused ion beam (FIB) are also available.
-
Multipurpose Bondtester
(Series 4000Plus:Nordson Advanced Technology Japan K.K.)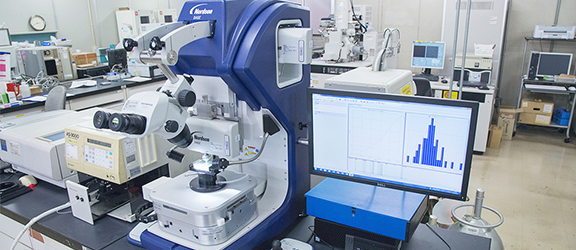
Bondtester is used for analyzing bond strength and fracture mode of soldering balls and bonding wires on substrates. Various sizes of soldering balls are available both for pull and shear tests.
-
Capillary Electrophoresis Instrument (CE)
(P/ACE MDQ:K.K. AB Sciex Japan)
CE is used for the analysis of impurities and ingredients in plating solutions. By electrifying mixed samples including plating solutions in a capillary tube, each ingredient is separated by the difference of migration speed.
-
Auger Electron Spectroscope (AES)
(SAM4300:ULVAC-PHI, Inc.)
AES is used for the elemental analysis of sample surfaces with depths of several nanometers. Further depth profile in the micrometer range is also available by argon sputtering. AES is effective for the measurement of the diffusion of under metal elements and trace foreign objects.
-
Focused Ion Beam System (FIB)
(FB-2100:Hitachi High-Technologies Corporation)
FIB is used for fabricating a sample to a state that enables cross sectional observation by etching the sample surface with a focused ion beam. FIB is also used for the observation of interface structures (intermetallic compounds and voids) between soldering balls and plated coatings.

